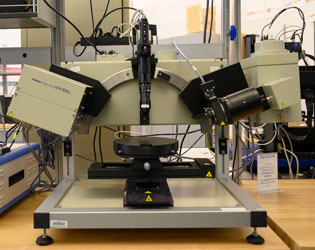
Spectroscopic Ellipsometry is a non-destructive technique that allows characterization of thin films, surfaces and interfaces. It is capable of measuring optical properties, film thickness, optical band gap, crystallinity, anisotropic structures and graded and non-uniform layers. Spectroscopic ellipsometry has applications in microelectronics and semiconductors, flat panel displays, optical coatings, optoelectronics, photovoltaics, solar cells, etc. Materials commonly studied are dielectrics, metals, semiconductors, polymers, organic materials and monolayers. The ADL has a phase-modulated spectroscopic ellipsometer, UVISEL from Horiba. Its main features are:
- UV-visible spectral ranges from 190 nm to 830 nm
- Allows film thickness measurements from few Angstroms to tens of microns for single layer and complex multilayer stacks for transparent and semi-transparent films
- Measures optical constants such as refractive index (n) and extinction coefficient (k) for bulk substrate and thin films
- Characterizes roughness layer, native oxide or an interface
- Calculation of optical band gap for compound alloys, Si and organic materials
- Capable of mapping film thickness and optical properties
- Can measure Reflectance and Transmittance
Instrument Manager: Anju Sharma
Back-up: Dae Young Jung